Tescan AMBER X™ 2
Tescan AMBER X™ 2 delivers the precision and throughput required for high-quality TEM and APT sample preparation while minimizing ion implantation and amorphization.
With its Xe plasma source and Mistral™ FIB column design, AMBER X™ 2 combines high-current milling for rapid material removal with fine beam resolution close to Ga FIB systems—preserving structural fidelity across sensitive materials.
- Xe plasma FIB: fast, non-reactive milling with minimal contamination
- Mistral™ FIB column: sharp beam profile for accurate thinning and polishing
- Wide current range: supports both bulk trenching and nanometer-scale finishing
- Integrated high-resolution SEM: ensures precise targeting and inspection
- Low-kV final polishing: reduces amorphization and maintains lattice detail
- Automation options: enable repeatable, site-specific sample preparation for advanced workflows







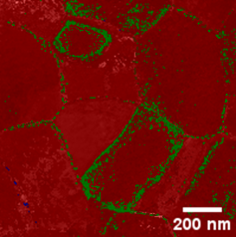

%20lamella%20prepared%20in%20trench%20after%20undercut-1.png?width=1070&height=1004&name=Large%20(55%20um%20x%2030%20um)%20lamella%20prepared%20in%20trench%20after%20undercut-1.png)

